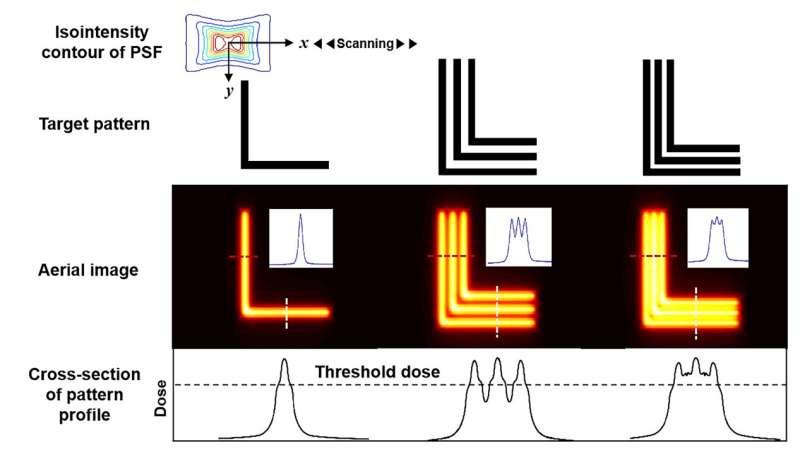
Fysiek begrip van de near-field OPE in plasmonische lithografie. Krediet: UCAS
Onderzoekers onder leiding van prof. Wei Yayi van de University of Chinese Academy of Sciences (UCAS) hebben de uiteindelijke patroongetrouwheid in near-field nanolithografie verbeterd, een doorbraak in het begrijpen van de near-field diffractielimiet van een verdwijnend-veld-gebaseerd patroonvormingssysteem.
De resultaten, gepubliceerd in Microsystemen en nano-engineeringis de eerste die de fysieke oorsprong van het nabije-veld optische nabijheidseffect (OPE) onderzoekt, en de theoretische berekeningen en simulatieresultaten geven aan dat het snel verdwijnende veld-geïnduceerde snelle verlies van hoge-k-informatie een van de belangrijkste optische bijdragers is naar het nabije veld OPE.
Omdat de functiegrootte continu wordt verkleind, vertoont het patroonprofiel dat wordt gegenereerd door een near-field lithografie een zeer slechte patroonkwaliteit vanwege de near-field OPE, ver onder de minimumvereiste voor nanofabricage. Daarom is het essentieel om de OPE in het nabije veld te minimaliseren om de hoogst mogelijke patroonresolutie en getrouwheid te bereiken met het plasmonische lithografieproces.
In deze studie onderzochten de onderzoekers de fysieke concepten achter de near-field OPE in een maskerloze plasmonische lithografie, en stelden een near-field optische nabijheidscorrectie (OPC) -methode voor via de ruimtelijke modulatie van nanopatronen om de uiteindelijke patroonkwaliteit te verbeteren.
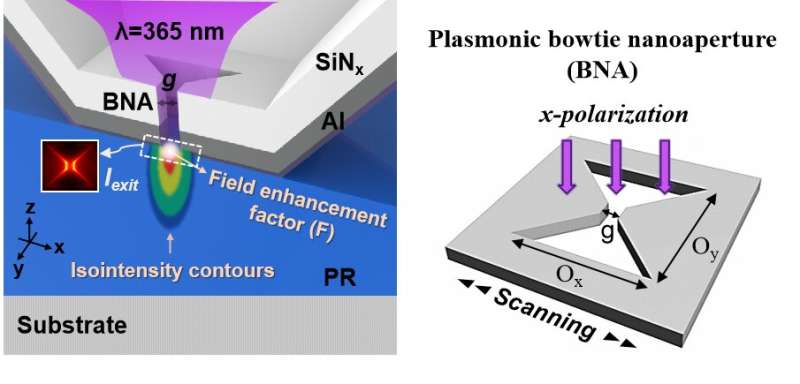
Schema van het maskerloze plasmonische lithografiesysteem met een scannende plasmonische bowtie-nanoopening. Krediet: UCAS
Nauwkeurige OPC vereist nauwkeurige belichting, dus werden numerieke berekeningen uitgevoerd om de puntspreidingsfunctie te schatten en kwantitatief het near-field enhancement-effect en de grootte-afhankelijkheid van het plasmonische near-field te analyseren.
Verder werd een analytische formule voorgesteld om het effect van het snel vervallende kenmerk van het verdwijnende veld op de OPE in het nabije veld en de theoretische limiet van de patroongetrouwheid kwantitatief te analyseren.
Met het oog op de kenmerken van de near-field OPE in plasmonische lithografie, werd een snelle en effectieve methode voor het corrigeren van het vluchtige veld-geïnduceerde high-k informatieverlies uitgevoerd door belichtingsdosiscompensatie vooraf in de belichtingsdosiskaart. En de simulatieresultaten toonden aan dat de uiteindelijke patroongetrouwheid aanzienlijk kan worden verbeterd.
Meer informatie:
Dandan Han et al, Verbetering van patroonkwaliteit in maskerloze plasmonische lithografie via ruimtelijke verliesmodulatie, Microsystemen en nano-engineering (2023). DOI: 10.1038/s41378-023-00512-4
Aangeboden door de Chinese Academie van Wetenschappen